| ¥价格面议 |
在不同电流密度下的分阶段电沉积实验展示了动态的硅通孔
(TSV) 填充过程。通过控制外加电流密度,可以获得对应于
TSV填充结果的不同形貌。具体来说,低电流密度 (4 mA/
cm 2 ) 会导致接缝缺陷填充,中等电流密度 (7 mA/cm 2 ) 会导
致⽆缺陷填充,⽽⾼电流密度 (10 mA/cm 2 )) 导致空洞缺陷填
充。填充系数分析表明,电流密度对TSV填充模型的影响是
由添加剂和铜离⼦的消耗和扩散的耦合效应触发的。此外,
镀层的形态演变表明局部沉积速率受镀层⼏何特征的影响。
硅通孔 (TSV) 是⼀种很有前途的三维 (3D) 封装技术,具有
⾼性能、减小封装体积、低功耗和多功能等优点。在 TSV ⼯
艺中,通常使用铜电化学沉积 (ECD) 进⾏的通孔填充步骤占
总成本的近 40% 。作为 TSV 的核⼼和关键技术,以小化⼯
艺时间和成本的⽆缺陷填充备受关注。
电子涂料 UV固化材料 晶圆划片保护液 晶圆临时键合减薄 导电银胶 烧结银 纳米银 道康宁 COB胶 红胶 SMT红胶 航空航天胶 耐高温胶 灌封胶 键合金丝 绝缘涂层键合金丝 脱泡机 平行封焊机 点胶机 键合机 KS劈刀 SPT劈刀 劈刀 陶瓷劈刀 洛德 汉高 道康宁 陶氏 X-RAY FIB FBI 武藏点胶机 诺信点胶机 灌封机 失效分析 快速封装 陶瓷管壳封装 COB封装 芯片键合封装 清洗液 晶圆清洗液 硅片清洗液 单晶硅清洗液 蓝宝石切割液 陶瓷划片清洗液 芯片粘接胶 IC粘接胶 IC导电胶 芯片导电胶 IC绝缘胶 汉高乐泰 汉高代理 汉高胶水 乐泰胶水 道康宁胶水 洛德胶 结构胶 汽车电子胶 COMS胶 传感器胶 传感器灌封胶 电子灌封胶 高导热环氧胶 高导热环氧灌封胶 高导热灌封胶 耐低温胶 光纤胶 尾纤粘接 光通信胶 透光胶 阻光胶 光耦胶 乐泰代理 ablestik胶 导热胶 导电导热胶 玻璃银胶 导电胶膜 绝缘胶膜 DAF膜 蓝膜 UV蓝膜 UV膜 导电胶脱泡机 底填胶 脱泡机 芯片胶 芯片导电胶 芯片粘接胶 芯片绝缘胶 CSP底部填充胶 叠die粘接 叠die导电胶 导电导热胶膜 5020胶膜 506胶膜 JM7000导电胶 84-1导电胶 ablestik导电胶 汉高导电胶 乐泰导电胶 洛德灌封胶 乐泰胶膜 芯片开盖机 胶水脱泡机 气密性检测 剪切力检测 芯片拉力测试 芯片陶瓷封装 芯片金属封装 晶圆钝化设备 晶圆刻蚀机 TSV晶圆沉积
目前对TSV填充的研究主要集中在条件优化和填充机理上。
为了实现⽆缺陷的 TSV 填充,电镀溶液中的特定添加剂,即
氯离⼦、抑制剂和促进剂进⾏了深⼊研究 。与特定添加剂和
通孔结构相对应的佳电沉积参数已被⼴泛研究。. 在这些参
数中,电流密度对填充形态的影响尤为显着。尽管特定的添
加剂可以有效地实现⽆缺陷填充,但所需的步骤很复杂,沉
积速率低,相关成本⾼。为了克服添加剂辅助填充⽅法的缺
陷,⼴泛研究了脉冲电流、脉冲反向电流、周期性脉冲反向
电流和多步电流等电镀电流波形. 同时,已经引用了⼏种机制
来解释⽆缺陷填充过程,例如传统的流平模型、对流相关吸
附模型、时间相关传输-吸附模型和曲率增强加速器覆盖模
型。动态 TSV 填充对于 TSV 填充研究的各个⽅面都很重要。
它是优化条件的基础,反映了填充模型的机制。然⽽,现有
的研究只关注在特定时刻获得的填充结果。很少系统地研究
连续和全面的动态 TSV 填充过程。在这项研究中,我们通过
在不同电流密度下的分阶段电沉积实验证明了 TSV 动态填充
过程。获得了实现⽆缺陷填充的佳电流密度。讨论了电流
密度对填充模型的影响。此外,镀层的形态演变表明,局部
沉积速率受镀层⼏何特征的影响。
北京汐源科技有限公司
随着电子产品 半导体产品不断的更新换代 在国家对高科技产业的大力支持下 汐源科技同时也为电子 半导体行业提供良好的保障。
汐源科技电子材料:
灌封胶:洛德 汉高 道康宁 陶氏 杜邦等。广泛应用于电子电源 厚膜电路 汽车电子 半导体封装等行业。
导电胶: 3M 北京ablestik 北京Emerson&Cuming等.用于半导体 LED等行业
实验设备:提供X-RAY FIB 显微镜等。FBI 武藏点胶机 诺信点胶机 灌封机 实验室仪器仪表 TSV电镀设备 键合机 平行封焊机。
我们的电子化学材料含括:粘接胶 灌封材料 导电 导热界面材料 裸芯粘接材料 COB包封材料 CSP/Flip chip/BGA底部填充胶 贴片胶 电子涂料 UV固化材料。应用范围涉及电子元器件 电子组件 电路板组装 显示及照明工业 通讯 汽车电子 智能卡/射频识别 航天航空 半导体封装 晶圆划片保护液 晶圆临时键合减薄 键合金丝等领域。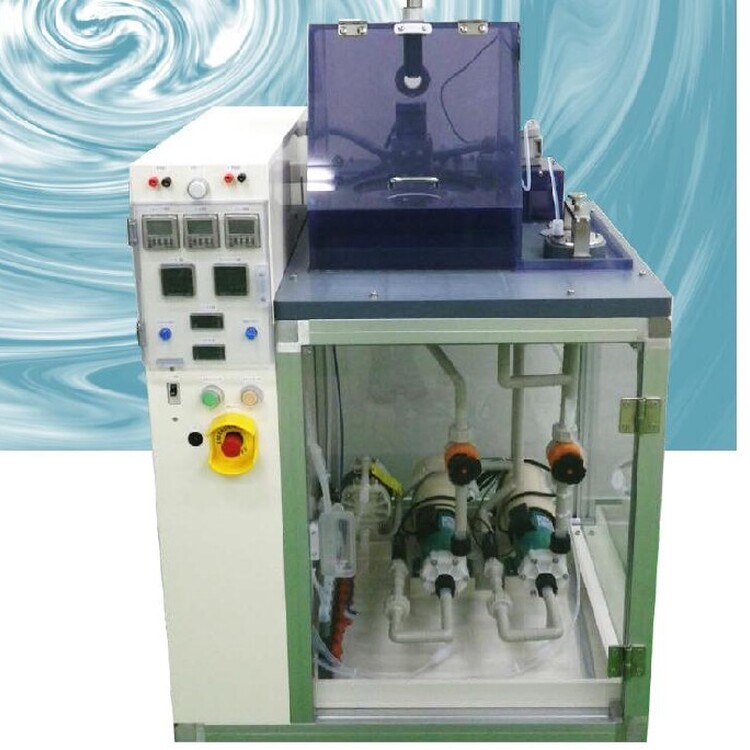
小型喷镀机台
配备有Stir Cup适用于研发以及小批量生产。
特别适合于镀孔,Sn/Ag电镀,Cu pillar等电镀制程。
铜凸块制程即wafer从晶圆加工完成基体电路后,利用涂胶、黄光、电镀及蚀刻制程等制作技术通过在芯片表面制作铜锡凸点,提供了芯片之间、芯片和基板之间的“点连接”,由于避免了传统Wire Bonding 向四周辐射的金属“线连接”,减小了芯片面积(封装效率),此外凸块阵列在芯片表面,引脚密度可以做得很高,便于满足芯片性能提升的需求,并具有较佳抗电迁移和导热能力以及高密度、低阻抗,低寄生电容、低电感,低能耗,低信噪比、低成本等优点。
北京汐源科技有限公司提供广东硅通孔填充⼯艺,铜电化学沉积,包括硅通孔填充⼯艺,铜电化学沉积,动态硅通孔填充⼯艺,TSV电镀的详细产品价格、产品图片等产品介绍信息。
北京汐源科技有限公司 6年
——— 认证资质 ———